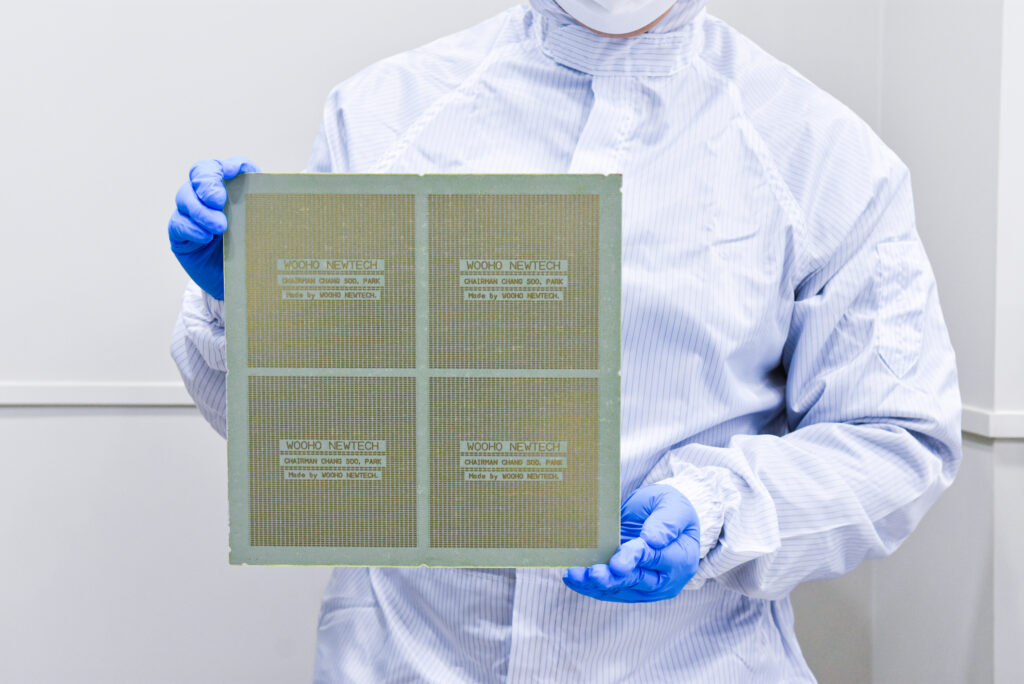
사진은 이번에 개발성공한 몰리브덴 기반 금속코어 TMV 기판.
우호뉴텍그룹, 세계 최초 ‘몰리브덴 기반 차세대 금속 코어 기판(TMV)’ 개발
.
- TMV는 AI, HPC 등 첨단 반도체 시장의 필수 기술
- 자체 R&D로 방열·전자파·대면적·휨 현상 등 기존 난제 해결
- 유리기판(TGV)의 파손 위험과 공정 난이도 극복… 기계적 강도와 내열성 확보
- 반도체패키징 패러다임 전환 기대
첨단 제조 설계·전문기업인 우호뉴텍그룹㈜이 세계 최초로 ‘몰리브덴(Molybdenum) 기반의 반도체용 금속코어기판 TMV(Through Metal Via)’ 개발에 성공했다고 밝혔다.
이 회사가 자체R&D로 개발한 몰리브덴 기반 TMV는 기존 반도체 패키징 기판기술이 구조적으로 해결하지 못했던 ▲방열 ▲전자파(EMI) ▲패널 대면적 사이즈 구현 ▲기판 뒤틀림(Warpage) ▲기계적 강도 ▲고온 내열성 등의 문제를소재·구조·공정 차원에서 근본적으로 해결한 차세대 기판 기술로 평가받고 있다.
AI·HPC 시대의 도래로 인한 기존 기판의 한계
인공지능(AI), 5G통신, 초대형 데이터센터·자율주행 등 고성능 컴퓨팅(HPC) 시장이 성장하면서차세대 고성능 반도체 칩은 더 미세화되고 고집적화되는 추세다.
반도체업계는 이런 흐름을 따라가기 위해 기존 반도체패키징 기판의 단점을 보완하고 기존 칩을 더 고밀도로 연결할 수 있는 새로운 기판 기술을 필요로 하고 있다.
특히 높은 연산밀도로 고속연산시 칩에서 발생하는 과도한 열, 패널을 크게 확장하는 과정에서 서로 다른 열팽창계수(CTE·Coefficient of Thermal Expansion)로 인해 적층구조 기판에서 발생하는 뒤틀림(Warpage) 등을 막는 것이 반도체시장의 최대 해결과제로 부상하고 있다.
기존 실리콘을 기반으로 한 TSV(Through Silicon Via) 유기소재 기판(Plastic)의 경우 열에 약하고 패널을 대면적화 할 때 쉽게 휘어지는 한계가 있어 차세대 칩 성능을 온전히 뒷받침하기가 어려워지고 있기 때문이다.
이에따라 반도체업계는 기존 TSV의 물리적 한계를 극복할 수 있는 고성능 반도체 패키징 소재로 유리기판의 TGV(Through Glass Via)를 주목해 왔다. TGV는 유리(Glass)에 관통홀(Via)을 형성해서 칩간의 전기적 신호를 수직으로 빠르게 전달할 수 있도록 설계된 기술이다. TGV는 정밀한 회로구현이 가능한 높은 평탄도, 열전도율, 치수 안정성이 기존 플라스틱 기반의 기판에 비해 우수한 점 때문에 고대역폭 메모리, AI 반도체, 고성능 컴퓨팅용 패키징 등에서 차세대 기판으로 부각되고 있다.
다만 유리기판(TGV)은 유리성질상 충격에 약해서 공정 중 파손위험이 크고, 사이즈를 키울 때 수율이 급격이 떨어지며 방열 대응과 EMI 대응이 어렵다는 단점을 여전히 가지고 있다.
"유리기판(TGV)을 넘어서다"… TMV만의 압도적 우위
우호뉴텍그룹이 이번에 개발에 성공한 몰리브덴 기반 TMV는 금속소재인 몰리브덴을 코어(Core)로 사용해 TGV의 한계를 극복해 내면서 TGV대비 명확한 기술적 우위를 점하고 있다.
금속이 갖는 특유의 강력한 기계적 강도를 바탕으로 파손위험이 거의 없으며, 대면적 패널 공정이 용이해 생산수율과 경제성 측면에서 훨씬 유리하다. 또 유리보다 열배출 및 고온안정 성질이 탁월해 효율적인 열 관리가 가능하며, 금속 소재 자체의 특성으로 전자파를 원천 차단하기 때문에 신호 무결성(Signal Integrity)을 보장한다.
아울러 몰리브덴은 기존 반도체 실리콘 칩과 열팽창계수(CTE)도 매우 유사해 고온의 공정이나 작동 환경에서도 기판이 휘거나 뒤틀리는 현상을 최소화할 수 있는 특징이 있다.
우호뉴텍그룹은 몰리브덴 기반 TMV를 통해 5가지 핵심 난제를 해결했다고 평가하고 있다.
- 획기적인 방열 성능(Heat Dissipation)
- 전자파 차폐(EMI Shielding)
- 대면적 사이즈 구현
- 휨 현상 방지
- 압도적인 기계적 강도와 내열성
이는 고성능 컴퓨팅(HPC) 칩의 성능 안정성을 극대화하고 수명을 연장하는 데 결정적 역할을 하게 된다.
향후 계획
우호뉴텍그룹은 TMV가 인공지능(AI), 고성능 컴퓨팅, 5G통신과 같은 차세대 반도체 분야에서 핵심적인 역할을 할 것으로 기대하며, TMV 기술개발을 기점으로 ▲AI 가속기 ▲서버용 CPU/GPU ▲자율주행차량용 반도체 ▲5G/6G 통신 모듈 등 고신뢰성이 요구되는 하이엔드 시장을 적극 공략해 나갈 계획이다.
세계적 시장조사기관들에 따르면 첨단 반도체 패키징 시장은 연평균 10% 이상 성장해 2030년에는 약 1000억 달러(한화 약 130조 원) 규모에 이를 것으로 전망된다.
우호뉴텍그룹 대변인은 다음과 같이 밝혔습니다.
"이번 몰리브덴 기반 TMV솔루션은 기존 반도체 패키징의 소재와 공정 패러다임을 바꿀 수 있는 혁신적 기술”이라며 "유리기판 TGV가 가진 태생적 한계를 넘어선 TMV기술을 통해 글로벌 반도체 소재·부품 시장에서 독보적인 지위를 확보해 나가겠다"
우호뉴텍그룹은 몰리브덴 기반 TMV 밸류체인 구축을 위해 글로벌 반도체 기업 및 AI·HPC 생태계 파트너들과 공동 안정성평가, 파일럿 라인구축 등 양산협력을 본격적으로 추진하고 차세대 공정까지 연구개발을 확대할 계획이다.